
椭圆偏振光谱是一种无损无接触的光学测量技术,基于测量线偏振光经过薄膜样品反射后偏振状态发生的改变,通过模型拟合后得到薄膜、界面和表面粗糙层的厚度以及光学性质等等,可测厚度范围为几埃至几十微米。而且,椭圆偏振光谱既能够实现在线监测又能进行原位测试,可根据各类不同的应用需要提供静态和动态测量模式,应用非常广泛。
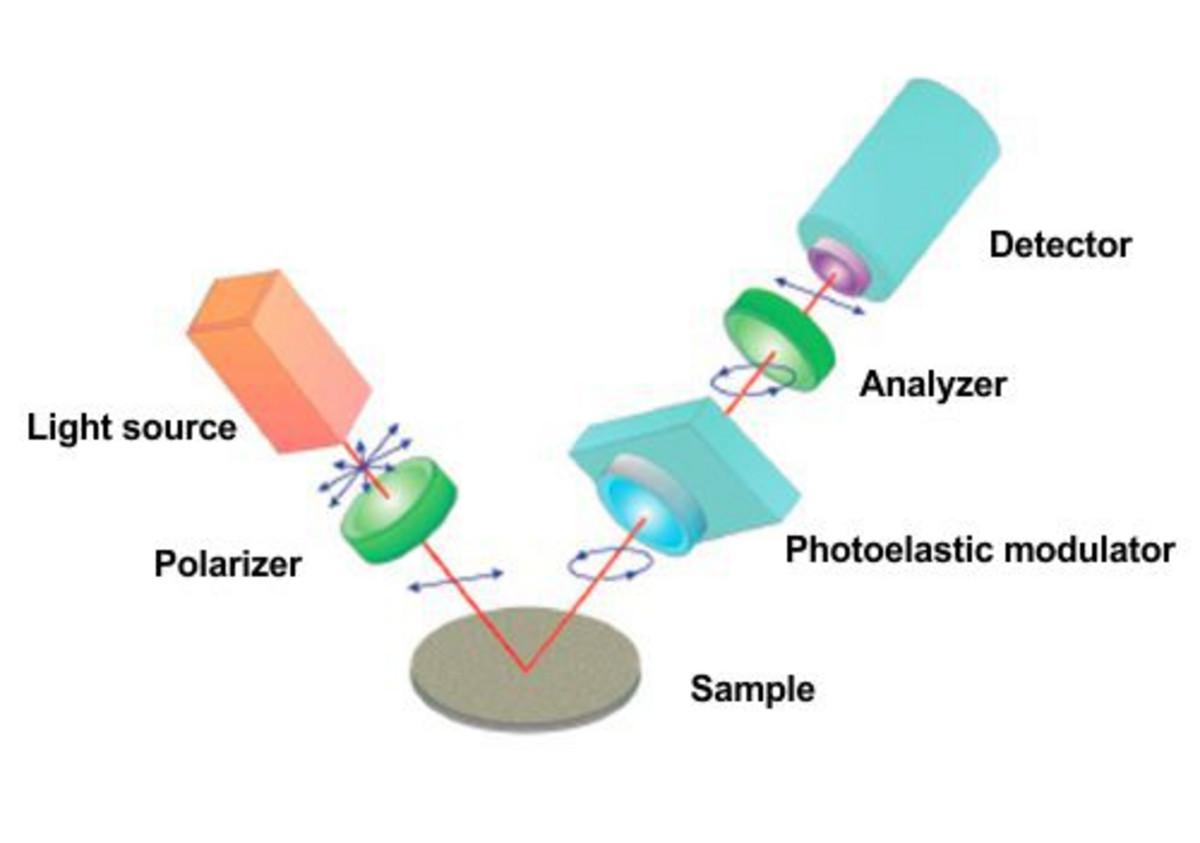
Fig.1: Optical setup of the UVISEL serie.
椭圆偏振光谱仪可以测量椭偏角ψ 和 Δ 这两个可以描述线偏振光经过薄膜反射后的椭圆偏振光的状态变化的参数。ψ 和Δ 与菲涅尔反射系数相关,满足方程ρ=tanψeiΔ= rp/rs 。
测量得到ψ 和Δ 后,必须建立一个薄膜的模型来确定厚度或者光学常数。
通常,椭圆偏振光谱仪不会直接测量ψ 和 Δ,而是测试ψ 和 Δ 的函数。在相位调制椭圆偏振光谱仪中,例如 UVISEL 和 UVISEL 2,可以测试Is, Ic 和 Ic’, 它们是ψ 和 Δ 的函数,即Is = sin2ψ sin Δ, Ic = sin 2ψ cos Δ, 和 Ic’ = cos 2ψ。通过Is 和Ic 可以精确测量0° ~360°范围的Δ,而通过Is 和 Ic’可以精确测量0° ~90°范围ψ。
Ex-situ spectroscopic ellipsometry.
椭圆偏振光谱方法并不能直接得到薄膜的厚度或者光学性质,它们必须通过模型获得。原位椭圆偏振光谱可以表征一系列薄膜性质,例如厚度、粗糙度、界面厚度、光学常数、组分、带隙、结晶度、坡度、各向异性,以及深度上和平面上的均匀性,也可以用于计算退偏因子和米勒矩阵系数。
In-situ spectroscopic ellipsometry can be used to determine nucleation and growth parameters, precise optical properties without significant surface roughness or oxides, and film growth profiles.
椭圆偏振光谱方法并不能直接得到薄膜的厚度或者光学性质,它们必须通过模型获得。除了膜厚和光学性质,在线椭圆偏振光谱还能用于确定成核和生长参数、刻蚀速率、样品表面属性的变化(氧化层的形成、表面污染、化学吸收等),以及获得薄膜生长剖面图。
椭圆偏振光谱是基于建模的测量技术,如果知道样品的信息(层数、材料等),会对得到结果非常有帮助。假设几乎没有样品信息,但只要是在已知基底上的单层薄膜,椭圆偏振光谱也同样可以进行研究。此外,在没有材料信息时,也可以分析基底的光学性质。
Polarization can be described as a superposition of two orthogonal waves.
偏振是由电场矢量的方向和相位决定的。我们可以认为偏振是两种正交波的叠加。考虑到两种正交波任意的相位差和相对振幅,最常见的偏振态是椭圆的。
Circular polarization is a special case of elliptical polarization. To obtain circular polarization, the two orthogonal waves must be 90° out of phase and have equal amplitudes.
圆偏振和线偏振是两种特殊的椭圆偏振。 对于圆偏振,正交波必须有90°的相位差和相同的振幅。
Linear polarization is a special case of elliptical polarization. To obtain linear polarization, the two orthogonal waves must be in phase but they may have arbitrary amplitudes.
对于线偏振,正交波必须有相同的位相但是可以有任意的振幅。
图片来自Fujiwara, H. “Spectroscopic Ellipsometry Principles and Applications,” John Wiley and Sons, 2007.
光学性质由两部分组成:折射率和消光系数。折射率,用 n 表示,是光在真空中的速度与光在材料中的速度之比。消光系数,用 k 表示,与光在材料中的吸收损耗有关。同时,这两部分构成了复折射率,由公式 N=n-ik 定义,用于表征光与材料相互作用(速度改变和吸收损耗)的电磁辐射。